Рефлектометрия в диапазоне 4-200 нм
Рефлектометр перекрывает широкий спектральный диапазон 4-200 нм. Он построен на базе двух монохроматоров РСМ-500 и LHT-30, которые соединены с одной камерой гониометра. Источником излучения для монохроматора РСМ-500 является рентгеновская трубка со сменными анодами. Данный монохроматор позволяет аттестовывать образцы в диапазоне 4-25 нм. Плечо монохроматора LHT-30 оборудовано газоразрядным источником. Спектральный диапазон данного прибора 25-200 нм. Таким образом, данная установка позволяет аттестовывать образцы как в МР так и в ВУФ диапазонах, не меняя дифракционной решетки или принципиальной схемы монохроматоров.
Еще одной отличительной и важной чертой данного рефлектометра является то, что камера гониометра стационарна, а ее размеры и вес фактически не ограничена. Сам гониометр имеет шесть степеней свободы и позволяет производить измерения достаточно массивных образцов (плоских, сферических, асферических) с максимальным диаметром 300 мм.
| Количество магнетронов | 2, 4 или 6 |
| Размер подложек | До 350 мм в диаметре |
| Форма поверхности подложек | Плоские, вогнутые или выпуклые. При наличии кривизны желательна осевая симметрия |
| Распыляемые материалы | Металлы, неметаллы — полупроводники, диэлектрики. Возможно распыление магнитных материалов |
| Скорость роста пленок | 0,1-1 нм/сек |
| Равномерность покрытия | Порядка 0,5% |
Технология магнетронного напыления
При ионно-плазменном (магнетронном) методе распыления применяется плазма тлеющего разряда. Понимание процессов, происходящих в тлеющем разряде, необходимо для постановки и интерпритации экспериментов по ионному распылению.
Тлеющий разряд
Если к двум электродам, расположенным в газе с низким давлением, приложить постоянное напряжение и вызвать эмиссию электронов из катода, то между электродами возникнет ток. С увеличением расстояния между электродами происходит увеличение тока, так как электроны при своем движении к аноду испытывают на единице длины пути определенное число ионизирующих столкновений с атомами газа, и чем больше путь, тем больше таких столкновений произойдет. Ионы, возникающие при таких столкновениях, ускоряются к катоду и могут, ударяясь, выбить вторичный электрон.
Известно, что тлеющий разряд состоит из областей, которые можно легко идентифицировать. Это (начиная от катода) область катодного свечения, темное катодное пространство, область отрицательного свечения, фарадеево темное пространство и положительный столб.
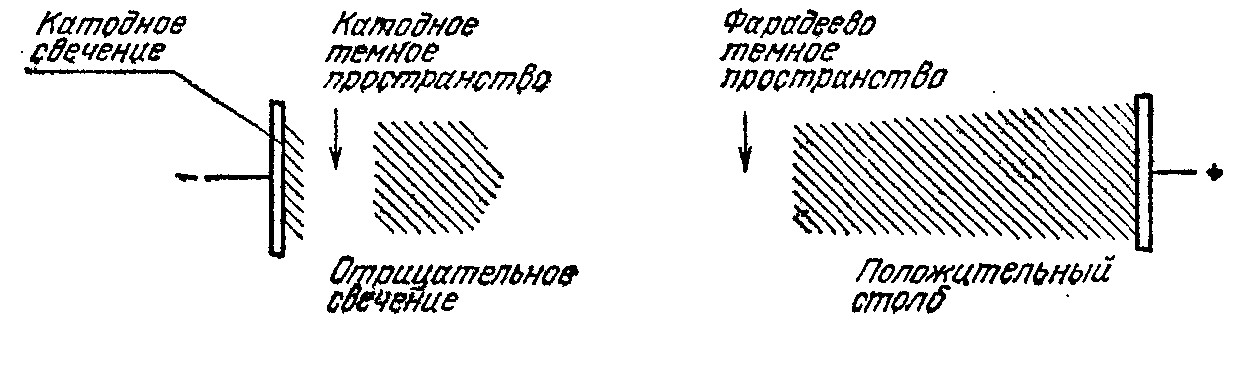
Наибольший интерес представляет область темного катодного пространства. Это область, в которой накапливаются положительные ионы, образуя пространственный заряд. Толщина ее приблизительно равна среднему расстоянию, которое проходят эмиттированные электроны до первого ионизирующего столкновения (не следует путать с длиной свободного пробега, которая может быть существенно меньше). Если катодное падение потенциала приближенно равно напряжению на разряде в целом (а в случае магнетронного распыления чаще всего так и бывает), то это разряд с преимущественно катодным падением потенциала.
При относительно низких напряжениях площадь поперечного сечения области разряда будет меньше всей площади катода. Это объясняется тем, что для существования самостоятельного разряда необходима некоторая минимальная плотность тока. Если к разрядной трубке подвести дополнительную мощность, площадь поперечного сечения разряда возрастет, полный ток увеличится, а плотность тока не изменится. Поскольку плотность тока не увеличится, то не возрастет и катодное падение потенциала. Это минимальное падение напряжения на темном пространстве, необходимое для поддержания разряда, называется нормальным катодным падением, а соответствующий разряд именуется нормальным разрядом.
Если мощность, подводимая к трубке, превысит некоторую величину, при которой разряд займет всю площадь катода, плотность тока должна возрасти. Это возможно лишь при увеличении эмиссии вторичных электронов, а это возможно лишь при увеличении катодного падения. Тлеющий разряд при этом называется аномальным.
При магнетронном напылении используется аномальный тлеющий разряд.
Разряд, поддерживаемый магнитным полем
Если повысить эффективность ионизации электронами атомов рабочего газа, то распыление можно было бы проводить при меньших давлениях, а при постоянном давлении для данного напряжения на электродах можно было бы получать больший ток.
Магнитное поле воздействует на тлеющий разряд, изменяя главным образом характер движения электронов. Влиянием магнитного поля на более тяжелые ионы можно пренебречь. При включении магнитного поля электроны, скорость которых непараллельна ему (т. е. имеется поперечная по отношению к магнитному полю составляющая скорости) , начинают двигаться по спиральным траекториям вокруг силовых линий магнитного поля. Вращение электронов происходит с циклотронной частотой.
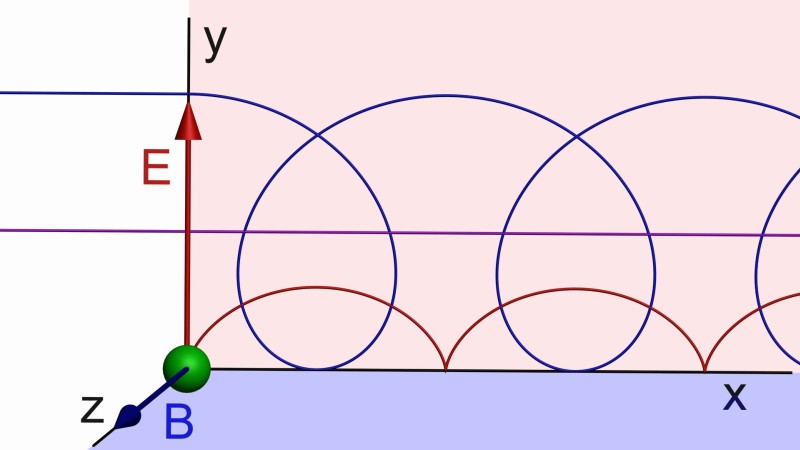
При этом радиус спирали уменьшается с увеличением магнитного поля. Следовательно, возрастает эффективная длина пути, проходимого электронами. В этом отношении действие магнитного поля подобно увеличению давления газа.
В случае однородных и параллельных электрического и магнитного полей электроны свободно ускоряются, и шаг их спиральной траектории непрерывно растет. Когда же электрическое поле перпендикулярно магнитному, общее направление дрейфа электрона перпендикулярно обоим полям. Траектория же движения будет циклоидальной.
Локализация электронов вблизи мишени предотвращает бомбардировку ими подложек, в результате чего снижается температура и уменьшаются радиационные дефекты в создаваемых структурах. Увеличение скорости распыления с одновременным снижением давления рабочего газа позволяет существенно снизить степень загрязнения пленок посторонними газовыми включениями.
Механизм магнетронного разряда
В магнетронных распылительных устройствах используется аномальный тлеющий разряд, локализованный у поверхности мишени в неоднородных скрещенных магнитном и электрическом полях. Основным отличием метода магнетронного распыления от других является создание над определенными участками катода (мишени) области плазмы тлеющего разряда низкого давления с более высокой, по сравнению с диодным распылением, плотностью путем наложения внешнего магнитного поля определенной формы на электрическое поле, направленное от катода к аноду.
Механизм магнетронного распыления характеризуется сложным движением электронов в зоне разряда, которое в общем случае можно разделить на четыре компонента:
- Геликообразное движение вдоль линий магнитного поля, которое является результатом их вращения вокруг вектора В и одновременно перемещения вдоль поля
- Отражение от катода вследствие наличия на нем отрицательного потенциала и градиента магнитного поля. В результате этого эффекта электроны отражаются в одну и другую стороны между точками, где линии поля проходят через поверхность мишени
- Дрейф электронов, обусловленный действием на них силы Лоренца в прикатодном пространстве (поля Е и В перпендикулярны друг другу), которая заставляет электроны двигаться параллельно катоду вокруг линий магнитного поля
- Анодный дрейф, представляющий перемещение электронов с одной линии поля на другую в направлении к аноду, который в конечном счете является коллектором низкоэнергетических электронов
Часто в магнетронах используется магнитное поле арочной конфигурации, позволяющее наиболее эффективно локализовать плазму у мишени за счет фокусирующих эффектов неоднородных полей. При арочном магнитном поле осуществляется магнитная фокусировка электронов, поскольку электроны, эмиттированные с краев зоны распыления, имеют преимущественно продольную составляющую скорости, направленную вдоль магнитного поля к середине зоны распыления. Увеличение концентрации электронов в центральной части зоны приводит к увеличению интенсивности ионизирующих столкновений и к росту плотности плазмы в этой области. В результате плотность ионного тока на мишень в центре зоны распыления будет выше, чем на краях.
Ширина темного катодного пространства обратно пропорциональна плотности ионного тока. Следовательно, эта область имеет вогнутую форму, и электроны, ускоряющиеся в темном катодном пространстве, приобретают под действием электрического поля скорость в направлении к центру зоны распыления, испытывая электрическую фокусировку. Аналогичный эффект дополнительно проявляется по мере эрозии мишени, когда зона распыления становится также вогнутой, что приводит к снижению рабочего напряжения и увеличению тока разряда.
Механизм магнетронного распыления реализуется в неоднородном магнитном поле, линии которого имеют значительную кривизну. В результате действия на электроны градиента магнитного поля создается своеобразная ловушка электронов, удерживающая их довольно долго в прикатодной области.
При этом обеспечивается весьма эффективная первичная ионизация рабочего газа, необходимая для осуществления эмиссии вторичных электронов.
Установка магнетронного распыления
Общая схема установки включает пост откачки, вакуумную камеру, блок электроники, персональный компьютер с установленной программой управления. Схематическое изображение установки приведено на рисунке:
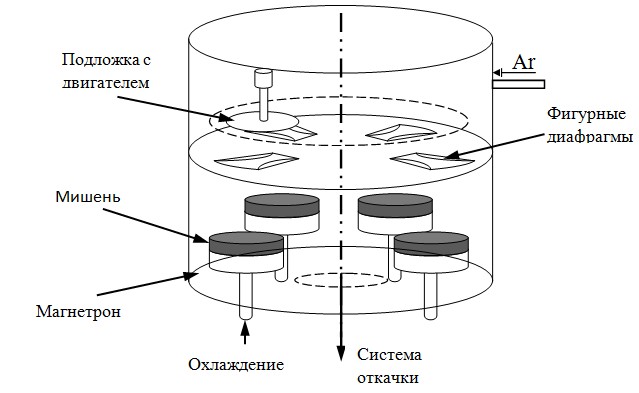
Пост откачки включает в себя безмасляные турбомолекулярный и форвакуумный насосы. С целью шумо- и виброизоляции форвакуумный насос удален из лаборатории в отдельное технологическое помещение. Остаточное давление газов в рабочей камере перед процессом изготовления зеркал не хуже 0,0001 Па.
Вакуумные камеры магнетронных установок представляют собой цилиндрический объем высотой до 0,5 м и диаметром от 0,5 до 1 м. Внутри по окружности установлены несколько (2, 4 или 6) планарных магнетронов. Над каждым магнетроном расположены фигурные прецизионные диафрагмы, обеспечивающие равномерное или с заданным распределением нанесение распыляемых материалов на подложку. Выше диафрагм расположен вращающийся экран, во вскрытом гнезде которого крепится подложка, имеющая возможность вращаться как вместе с экраном вокруг оси камеры, так и независимо вокруг своей оси.
Каждый магнетрон представляет собой источник с кольцевым разрядом, то есть с магнитным полем арочной конфигурации. На поверхности расположена катод-мишень распыляемого материала. Для круглым магнетронов диаметром 150 мм, для протяженных шириной 140 мм и длиной 350 мм. Как правило, толщина мишеней находится в пределах от 2 мм до 8 мм. Магнитная система магнетрона создает в зазоре между полюсами постоянное магнитное поле напряженностью 0,04-0,07 Тл. Источниками питания магнетронов служат стабилизированные блоки на постоянном токе, нашей разработки и сборки. Они позволяют варьировать ток разряда в пределах 100-2000 мА при напряжениях от 100 до 500 В. Для высокочастотного распыления мишеней (как правило, диэлектрических) используется блок фирмы «Balzers» с частотой 13,56 МГц. Охлаждение магнетронов производится за счет принудительной подачи воды с помощью помпы. Тепловой контакт мишени с магнетроном обеспечивается герметиком «Виксинт» с медным наполнителем. В качестве рабочей среды используется высокочистый (99,998%) газ аргон. Рабочее давление газа при технологическом процессе составляет 0,08-0,13 Па.
Скорость напыления можно регулировать изменением токов на магнетронах, а так же скоростью прохождения подложки над ними. Характерные значения скорости роста пленок составляют порядка 0,1-1 нм/сек.
Высокие требования к параметрам периодических структур накладывают жесткие условия на стабильность параметров технологического процесса. Решение этой задачи достигается путем использования программно-аппаратного комплекса на базе PC-совместимого промышленного контроллера i-8431. Контроль и протоколирование параметров процесса напыления осуществляется с помощью персонального компьютера.
Забродин, И.Г. Установка магнетронного и ионно-пучкового напыления многослойных структур / И.Г. Забродин, Б.А. Закалов, И.А. Каськов, Е.Б. Клюенков, В.Н. Полковников, Н.Н. Салащенко, С.Д. Стариков, Л.А. Суслов // Поверхность. Рентгеновские, синхротронные и нейтронные исследования. – 2013. – №7. – С.37-39.
Zabrodin, I.G. Apparatus for the Magnetron and Ion-Beam Synthesis of Multilayer Structures / I.G. Zabrodin, B.A. Zakalov, I.A. Kaskov, E.B. Klyuenkov, V.N. Polkovnikov, N.N. Salashchenko, S.D. Starikov, L.A. Suslov // Journal of Surface Investigation. X-ray, Synchrotron and Neutron Techniques. – 2013. – V.7No.4. – P.637-640.

Полковников Владимир Николаевич
Заведующий лабораторией
в отделе рентгеновской оптики, к. ф.-м. н.